A pesar del creciente uso de la litografía EUV, los defectos estocásticos no han desaparecido. Lo que se está volviendo más claro es que las dosis de EUV deben administrarse para minimizar el impacto de tales defectos. La edición 2022 de International Roadmap for Devices and Systems ha actualizado su parte de litografía [1]. Se ha revelado una tendencia ascendente con un tamaño de característica decreciente (Figura 1).
Figura 1. El Capítulo de Litografía del IRDS 2022 proyecta dosis crecientes de EUV para diámetros decrecientes. Estas dosis graficadas dan números de fotones de 4000-7000 dentro de +/-5% CD del borde. El número de fotones disminuye con la disminución del diámetro.
La aparición de defectos estocásticos en realidad define una ventana de dosis de EUV [2]. Las consecuencias de salir de esta ventana se muestran en la Figura 2.

Figura 2. Los orificios de contacto de paso de 40 nm tienen ventanas de dosis definidas por la aparición de estocásticos. Una dosis demasiado baja (izquierda) da como resultado una absorción de fotones insuficiente dentro del área circular objetivo (ejemplo: puntos azules dentro de un círculo). Una dosis demasiado alta (derecha) da como resultado espacios estrechos entre las características en las que se pueden formar puentes (píxeles adyacentes rodeados parcialmente llenos de naranja) debido a la absorción excesiva de fotones. El tamaño de píxel es de 1 nm x 1 nm.
Una dosis demasiado baja da como resultado la absorción de muy pocos fotones, lo que conduce a defectos de tipo subexposición, como contactos faltantes, deformados o de tamaño insuficiente. Por otro lado, una dosis demasiado alta da como resultado defectos de tipo sobreexposición, donde los espacios entre las áreas expuestas se cierran accidentalmente. De una multitud de estudios sobre este tema, se entiende que la aparición de defectos se minimiza (si no se elimina por completo) dentro de algún rango entre los dos límites. Podemos esperar que esta ventana de dosis se desplace hacia valores más altos a medida que se reduzcan los tamaños de las características.
La tendencia hacia dosis más altas obviamente impulsará la energía de la fuente hacia objetivos más altos [3]. Sin embargo, incluso a 500 W, las dosis superiores a 100 mJ/cm2 impulsarán el rendimiento por debajo de 100 obleas por hora (Figura 3).
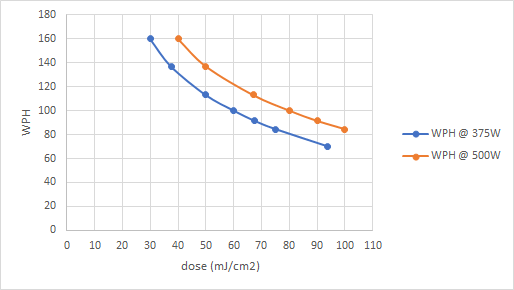
Figura 3. Rendimiento frente a dosis, en función de la potencia de la fuente. La calibración se basa en la Fig. 15 de la Ref. 3.
El aumento de la energía de la fuente también es un problema de impacto ambiental. Las máquinas EUV ya consumen más de un MW cada una [4]. Para poder pasar más obleas por día a través de cada máquina, es posible que se deba considerar el multipatrón [5]. Las dosis más bajas estarían bien para las características expuestas más grandes, pero estas necesitan una contracción posterior a la litografía y deben empaquetarse sucesivamente en los pasos más ajustados, como ya se practica con la litografía DUV.
Referencias
[1] https://irds.ieee.org/editions/2022/irds%E2%84%A2-2022-lithography
[2] J. van Schoot et al., ""Herramienta de exposición EUVL de alta NA: ventajas clave y estado del programa", Proc. SPIE 11854, 1185403 (2021).
[3] H. Levinson, "Litografía EUV de alta NA: estado actual y perspectivas para el futuro", Jpn. Aplicación J. física 61 SD0803 (2022).
[4] P. van Gerven, https://bits-chips.nl/artikel/hyper-na-after-high-na-asml-cto-van-den-brink-isnt-convinced/
[5] A. Raley et al., "Perspectivas para patrones de EUV de alta NA: un enfoque de patrones holísticos para abordar los próximos desafíos", Proc. SPIE 12056, 120560A (2022).
Lea también
Litografía específica de la aplicación: patrón de puerta de nodo de 5 nm
Limitaciones de resistencia y llenado de pupila de EUV a 3 nm
Comparte esta publicación a través de:



