Para una tecnología de litografía de vanguardia, la litografía EUV (ultravioleta extremo) todavía está plagada de algunos problemas fundamentales. Si bien los defectos que ocurren estocásticamente probablemente han sido los más discutidos, otros problemas, como los cambios de imagen y el desvanecimiento [1-5], son una parte intrínseca del uso de ópticas EUV reflectantes. Sin embargo, siempre que estos problemas no estocásticos puedan modelarse sistemáticamente, de manera efectiva como aberraciones, se pueden aplicar enfoques correctivos.
Los cambios de imagen son una parte inevitable de la litografía EUV por una variedad de razones, incluida la posición de la característica en la máscara y la posición de la máscara [6]. Sin embargo, en cualquier posición dada de y sobre la máscara, se producen cambios de imagen porque la imagen en realidad está compuesta de subimágenes de ángulos de reflexión más pequeños y más grandes de la máscara EUV. Los ángulos más grandes son generalmente de menor amplitud y se desplazan en una dirección con el desenfoque, mientras que los ángulos más pequeños son generalmente de mayor amplitud y se desplazan en la dirección opuesta con el desenfoque. El efecto combinado es tener un pequeño cambio neto con desenfoque (Figura 1). Si las amplitudes de los ángulos más pequeños y más grandes fueran las mismas, no habría cambio [3].
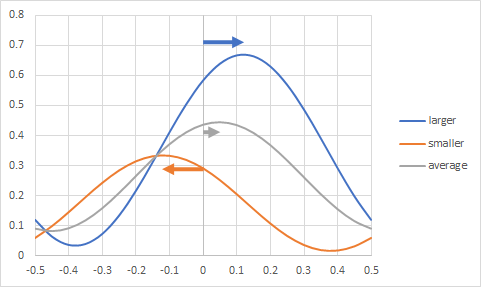
Los cambios medidos y la mejor posición de enfoque son funciones no triviales tanto del ángulo de iluminación como del tono [1]. A partir de la Figura 2, en base a estas mediciones en un sistema de 0.33 NA, también podemos seleccionar las iluminaciones que mejor se adaptan a tonos particulares.

Por ejemplo, el paso de línea horizontal de 32 nm se combina mejor con la forma de dipolo de 0.8/0.5 (intervalo de 45 grados, sigma interno de 0.5, sigma externo de 0.8). Por otro lado, la forma de dipolo 0.7/0.4 parece coincidir mejor con un paso de línea horizontal de alrededor de 37 nm, o más cerca de 37.3 nm. Por lo tanto, idealmente, un patrón que contenga estos dos pasos debe imprimirse en dos partes, una con una iluminación de 0.8/0.5 para la parte que contiene un paso de 32 nm y otra con una iluminación de 0.7/0.4 para la parte que contiene un paso de 37.3 nm. Esto resolvería tanto la mejor diferencia de enfoque como los problemas de cambio de imagen de desenfoque para estos dos tonos.
Sin embargo, queda otro problema relacionado con los turnos. La posición de la imagen en el mejor enfoque es diferente para diferentes tonos. Afortunadamente, esto se puede corregir de una manera sencilla mediante el método sugerido en la Ref. 4. El cambio se puede compensar directamente como diferentes posiciones de exposición. Además, el desvanecimiento se puede eliminar aún más dividiendo la iluminación del dipolo en dos exposiciones, una para cada monopolo [4]. Esto permite la superposición perfecta de las imágenes de cada uno de los dos polos (Figura 3). Esto significaría un total de cuatro exposiciones para los tonos de 32 nm y 37.3 nm. Además, la superposición debe ser ajustada para que se cancelen los cambios (<1nm). La dosis se reduciría a 1/4 de la dosis original para cada exposición. Sin embargo, el rendimiento aún puede verse afectado por el menor llenado de la pupila (<20 %) del monopolo. Una posibilidad de alivio es expandir el ancho del monopolo para aumentar el llenado de la pupila, al menos para algunos de los tonos que se apuntan.

Este enfoque de exposición múltiple se puede generalizar a patrones bidimensionales, cubriendo más campos. En combinación con la posición de la máscara y los ajustes dependientes de la posición de la máscara, es la única forma verdaderamente rigurosa de corregir por completo las aberraciones de cambio de imagen en la litografía EUV.
Referencias
[1] F. Wittebrood et al., "Verificación experimental de los efectos 3D de la máscara inducida por fase en las imágenes de EUV", Simposio internacional de EUVL 2015 - Maastricht.
[2] T. Brunner et al., "Litografía de campo oscuro EUV: resolución extrema mediante el bloqueo de orden 0", Proc. SPIE 11609, 1160906 (2021).
[3] F. Chen, "Cambio de imagen inducido por desenfoque en litografía EUV", https://www.youtube.com/watch?v=OXJwxQK4S8o
[4] JH. Franke, TA Brunner, E. Hendrickx, "Estrategia de exposición de monopolo dual para mejorar las imágenes ultravioleta extremas", J. Micro/Nanopattern. Mate. Metrol. 21, 030501 (2022).
[5] JH. Franke et al., "Mejorando las latitudes de exposición y alineando el mejor enfoque a través del tono curando los efectos de fase M3D con aberraciones controladas", Proc. SPIE 11147, 111470E (2019).
[6] F. Chen, "Cambios de patrón en la litografía EUV", https://www.youtube.com/watch?v=udF9Dw71Krk
Este artículo apareció por primera vez en LinkedIn Pulse: Exposiciones monopolares múltiples: ¿la forma correcta de controlar las aberraciones en la litografía EUV?
Lea también
Litografía específica de la aplicación: Sub-0.0013 um2 Patrón de nodo de almacenamiento DRAM
Comparte esta publicación a través de:
- Distribución de relaciones públicas y contenido potenciado por SEO. Consiga amplificado hoy.
- Platoblockchain. Inteligencia del Metaverso Web3. Conocimiento amplificado. Accede Aquí.
- Fuente: https://semiwiki.com/lithography/324136-multiple-monopole-exposures-the-correct-way-to-tame-aberrations-in-euv-lithography/



