El reciente logro de China de un nodo de fundición de clase 7 nm que utiliza únicamente litografía DUV [1] plantea la cuestión de hasta qué punto se puede extender la litografía DUV mediante patrones múltiples. Una publicación reciente en CSTIC 2023 indica que grupos chinos están estudiando actualmente la extensión del multipatrón basado en DUV a 5 nm, llegando incluso a considerar el uso de 6 máscaras para una capa [2]. La comparación de los enfoques basados en DUV y EUV que avanzan hacia los 3 nm lleva a una conclusión interesante.
Patrones LELE
La forma más básica de multipatrón es el llamado enfoque “Litho-Etch-Litho-Etch” (LELE), que consiste esencialmente en realizar la litografía básica seguida de un grabado dos veces. Esto permite reducir el paso a la mitad, ya que se inserta una segunda característica entre dos primeras características impresas. Por extensión, pueden seguir LE3 (3xLE) y LE4 (4xLE). Sin embargo, ya no se prefiere el uso de estos enfoques para llegar a menos de la mitad del paso original, con la llegada de los patrones espaciadores autoalineados.
Patrón de espaciador autoalineado
El patrón de espaciador autoalineado tiene la ventaja sobre LELE de no requerir un paso de litografía adicional, ahorrando así costos adicionales. La deposición del espaciador y el posterior grabado, seguido del relleno de huecos y el posterior grabado, reemplazan la capa, hornean, exponen, hornean y desarrollan la secuencia de litografía. Si bien es mucho más económico, aún se requiere un control preciso del proceso, como el espesor del espaciador y la selectividad de la velocidad de grabado. Una aplicación única del espaciador conduce a la duplicación de características dentro de un tono determinado. Por lo tanto, esto a menudo se denomina patrón doble autoalineado (SADP). La nueva aplicación conduce a un patrón cuádruple autoalineado (SAQP), como era de esperar.
Patrones sustractivos
Si bien LELE y SADP agregan naturalmente características a un patrón, a veces es necesario eliminar partes de esas características para el diseño final. Las máscaras de corte indican áreas donde se deben eliminar segmentos de línea. También se denominan ubicaciones de bloqueo cuando se bloquea el grabado que forma la línea. La máscara inversa se llama máscara de retención. Restringir un salto de línea a un solo ancho de línea tiene problemas de ubicación si la línea adyacente también se puede grabar. Cuando se pueden organizar líneas alternativas para que estén hechas de diferentes materiales para grabar, se pueden hacer saltos de línea con mejores tolerancias (Figura 1).
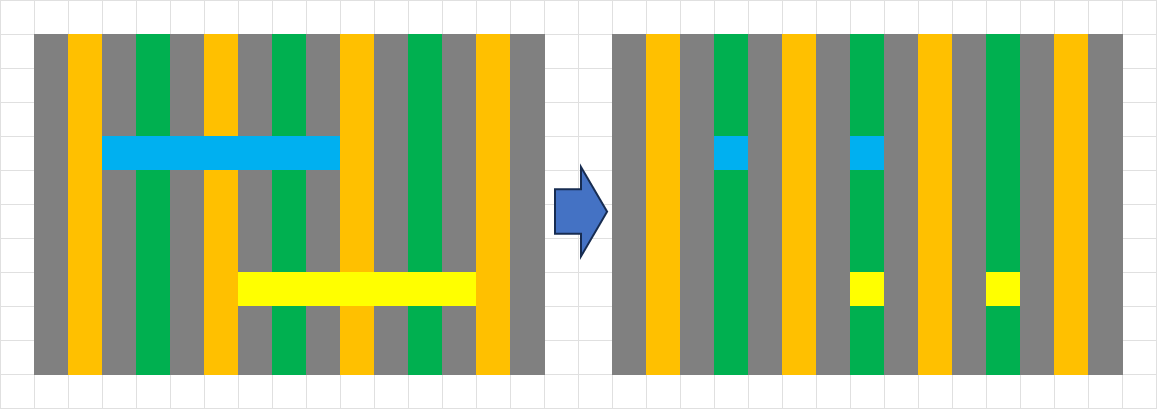
Figura 1. El bloque/corte autoalineado solo elimina secciones de líneas alternativas.
Para una línea de interconexión determinada, se espera que la distancia entre cortes sea de al menos dos pasos de metal. Por lo tanto, se esperan dos máscaras por línea cuando el paso del metal es de 1/4 a 1/2 del límite de resolución.

Figura 2. Se requieren dos juegos de máscaras de bloqueo/corte para los dos juegos de grabado.
Disposición de línea alternativa
La disposición de las líneas alternas es natural mediante LELE, SADP, SAQP o un híbrido de LELE y SADP conocido como SALELE (LELE autoalineado) [3]. SALELE ya se ha considerado el uso predeterminado de EUV para los pasos de metal más estrechos [2, 4].
Evaluación de costos DUV versus EUV
Una de las expectativas para el multipatrón con DUV ha sido el costo creciente en relación con EUV. Es hora de una reevaluación actualizada. En primer lugar, utilizamos las últimas estimaciones de costos de patrones normalizados (2021) [5] (Figura 3).

Cifra. 3 Costos normalizados para el modelado, de la Referencia 5.
A continuación, utilizamos estilos de patrones representativos para DUV y EUV para los distintos nodos (Figura 4).

Figura 4. Costos de patrones DUV versus EUV versus nodo
Varios comentarios están en orden:
- Para DUV de 7 nm, el paso de 40 nm es un punto en el que las únicas características que se pueden resolver son las líneas, por lo que estas líneas deben cortarse en una exposición separada.
- Para EUV de 7 nm, se utiliza un corte de línea separado ya que con un paso de 40 nm, la resolución requerida (~20 nm) es menor que la función de dispersión de puntos del sistema EUV (~25 nm). Un sistema EUV High-NA tampoco es ventajoso para este tono, debido a las limitaciones de profundidad de enfoque y llenado de la pupila [6].
- Para DUV de 3/5 nm, LELE SADP es más flexible que SAQP para un paso inferior a 40 nm [7].
- Para EUV de 3/5 nm, la fuerza impulsora del uso de LELE es el comportamiento estocástico a <17 nm de medio paso y <20 nm de ancho de línea aislado [8,9]. A medida que nos acercamos a las dimensiones de 10 nm, el desenfoque dependiente de la dosis de dispersión de electrones [10-12] también se volverá prohibitivo. La resolución óptica del sistema, es decir, NA, ya no es relevante.
- La conformación del patrón no se considera una forma de eliminar los cortes, ya que dificultaría mucho la litografía de preconformación (Figura 5). Además, el grabado con haz de iones en ángulo se ha utilizado generalmente para aplanar la topografía preexistente, reduciendo la altura de la máscara de grabado [13].

Figura 5. Para dar forma al patrón, el patrón antes de darle forma es muy hostil a la litografía.
En su mayor parte, podemos juzgar directamente que DUV LELE es mucho más barato que la exposición única (SE) EUV. Además, DUV LE4 es más barato que el patrón doble EUV. Aunque LELE requiere pasos adicionales sobre SE, también existe la consideración del mantenimiento del sistema EUV frente al mantenimiento del sistema DUV, así como el consumo de energía. DUV LELE utiliza la mitad de energía que EUV SE, DUV SADP alrededor de 2/3 e incluso DUV LE4 utiliza poco menos del 85% de la energía de EUV SE [14].
Todo esto sirve para resaltar que pasar a nodos avanzados requiere enfrentar costos crecientes, independientemente de la elección de DUV o EUV.
Referencias
[ 1 ] https://www.techinsights.com/blog/techinsights-finds-smic-7nm-n2-huawei-mate-60-pro
[2] Q. Wu et al., CSTIC 2023.
[3] Y. Drissi et al., Proc. SPIE 10962, 109620V (2019).
[4] R. Venkatesan y col., Proc. SPIE 12292, 1229202 (2022).
[5] S. Snyder et al., Taller EUVL de 2021, https://www.euvlitho.com/2021/P2.pdf
[6] F. Chen, Cuando la NA alta no es mejor que la NA baja en litografía EUV, 2023, https://www.youtube.com/watch?v=10K5i4QdLBU
[7] S. Sakhare et al., Proc. SPIE 9427, 94270O (2015).
[8] L. Meli et al., J. Micro/Nanolith. MEMS MOEMS 18, 011006 (2019).
[9] D. De Simone y G. Vandenberghe, Proc. SPIE 10957, 109570Q (2019).
[10] A. Narasimhan et al., Proc. SPIE 9422, 942208 (2015).
[11] I. Bespalov et al., ACS Appl. Madre. Interfaces 12, 9881 (2020).
[12] F. Chen, Modelado de defectos estocásticos EUV con desenfoque electrónico secundario, https://www.linkedin.com/pulse/modeling-euv-stochastic-defects-secondary-electron-blur-chen
[13] M. Ulitschka y otros, J. Europ. Optar. Soc. – Pub rápido. 17:1 (2021).
[14] Los Ángeles. Ragnarsson et al., 2022 Electron Dev. Tecnología. Manuf., 82 (2022).
Este artículo apareció por primera vez en LinkedIn Pulse: Extensión del multipatrón DUV hacia 3 nm
Lea también
Modelo estocástico para la difusión de ácido en resistencias DUV amplificadas químicamente
Modelado de defectos estocásticos EUV con desenfoque electrónico secundario
Comparte esta publicación a través de:
- Distribución de relaciones públicas y contenido potenciado por SEO. Consiga amplificado hoy.
- PlatoData.Network Vertical Generativo Ai. Empodérate. Accede Aquí.
- PlatoAiStream. Inteligencia Web3. Conocimiento amplificado. Accede Aquí.
- PlatoESG. Carbón, tecnología limpia, Energía, Ambiente, Solar, Gestión de residuos. Accede Aquí.
- PlatoSalud. Inteligencia en Biotecnología y Ensayos Clínicos. Accede Aquí.
- Fuente: https://semiwiki.com/lithography/336182-extension-of-duv-multipatterning-toward-3nm/



