Los sistemas de litografía ultravioleta extrema (EUV) son los sistemas de litografía más avanzados que se utilizan en la actualidad. Este artículo es una introducción básica a esta importante pero compleja tecnología.
El objetivo: una longitud de onda más pequeña
La introducción de la longitud de onda de 13.5 nm continúa una tendencia que la industria de los semiconductores había seguido con una reducción de la longitud de onda desde el uso de la luz azul (longitud de onda de "línea g" de 436 nm) para tamaños de características > 1 micrón. La luz se proyecta a través de una máscara (o “retícula”) que tiene impreso el patrón del circuito. La imagen transmitida luego se reduce cuando finalmente se proyecta sobre la oblea. El tono mínimo es la mitad de la longitud de onda dividida por la apertura numérica (NA) del sistema. La NA de un sistema óptico es un número adimensional que indica el rango de ángulos sobre los cuales la lente final puede enfocar la luz. La reducción de la longitud de onda no es trivial, ya que significa que la energía de los fotones aumenta en proporción inversa. En consecuencia, hay una alta absorción en todos los materiales. Por lo tanto, se necesitan sistemas ópticos fuera del eje totalmente reflectantes. Esto ha llevado al desarrollo de los llamados sistemas de proyección de "campo anular", que conducen a la rotación de la iluminación a lo largo del campo de exposición [1]. Los sistemas ópticos anteriores a EUV podían basarse en ópticas transmisivas en el eje, lo que simplificaba la configuración de iluminación al no tener rotación.
Una máscara diferente
El uso de la longitud de onda EUV también condujo a una revisión de la estructura de la máscara. La máscara es también un elemento reflectante. La reflexión se logra con una multicapa compuesta por al menos 40 bicapas de molibdeno/silicio. El patrón de máscara utiliza una capa absorbente, actualmente basada en tantalio, que tiene varias longitudes de onda de espesor. Con la iluminación fuera del eje dispersándose a través del patrón absorbente y propagándose y reflejándose a través de la multicapa, los efectos 3D son inevitables al afectar la imagen final en la oblea [2].
La máscara también está protegida por una membrana delgada llamada película, que sobresale a cierta distancia de la superficie de la máscara. Desarrollar una película para EUV fue un gran problema, ya que la luz tiene que atravesarla dos veces como elemento transmisor no reflectante.
Cambiar la apertura numérica
La apertura numérica en los sistemas EUV actuales es de 0.33. En una futura generación de sistemas EUV, la apertura numérica se incrementará a 0.55. Se espera que esto permita tamaños de características 0.6 veces más pequeños, a partir de la proporcionalidad longitud de onda/NA. Sin embargo, se espera que la profundidad de enfoque sufra al reducirse más rápido que la resolución, ya que es aproximadamente proporcional a la longitud de onda/(NA)^2 (Figura 1) [3]. Para 0.55 NA EUV, esto ha generado preocupaciones con el uso de resistencia (la capa de imagen absorbente en la oblea) tan delgada como 20 nm [4].

Un sistema de 0.55 NA tiene complicaciones adicionales. Primero, es un sistema de medio campo, lo que significa que se necesitan dos escaneos de máscara para llenar la misma área que un solo escaneo de máscara en un sistema anterior [5]. En segundo lugar, existe un oscurecimiento central proyectado por los dos últimos elementos ópticos. Esto restringe la iluminación así como ciertas combinaciones de tonos [6]. Finalmente, la polarización se vuelve importante para tonos que pueden hacer uso de 0.55 NA [7].
El oscurecimiento es la diferencia sistemática fundamental que afecta la escala proyectada de los sistemas 0.33 NA actuales. Habrá pérdida de luz justo antes de llegar al elemento de enfoque final. Además, la calidad de la imagen cambiará fundamentalmente. Componentes clave del espectro de difracción de imágenes. La figura 2 muestra una línea brillante con un tono de 68 nm bajo iluminación adaptada para un tono de 28 nm. La apariencia es normal sin oscurecimiento, pero con el oscurecimiento en su lugar, el pico central se reduce y los lóbulos laterales a su lado se realzan, ya que se elimina el primer orden de difracción. Estos lóbulos laterales pueden imprimir estocásticamente [8].
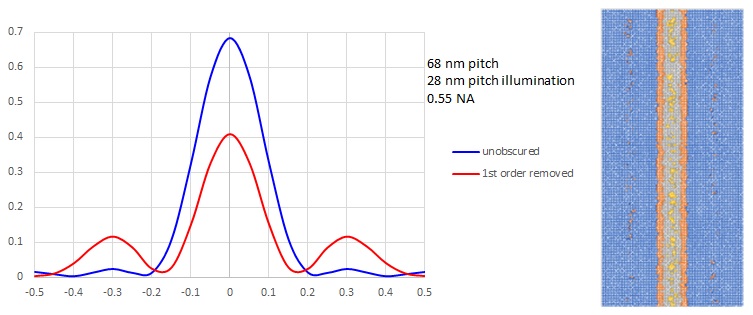
No es solo la luz EUV...
Lamentablemente, la litografía EUV está plagada de una serie de factores que no son evidentes a partir del tratamiento óptico clásico considerado hasta ahora. La luz EUV es una forma de radiación ionizante, lo que significa que libera electrones en la resistencia al absorberse. Los fotoelectrones (~80 eV) son de la ionización directa, y los electrones secundarios son de la ionización causada por estos y los electrones liberados posteriormente. La energía depositada por la dispersión de electrones obviamente calentará la resistencia, lo que provocará la desgasificación, lo que contaminará los elementos ópticos del sistema EUV. Por esta razón, los sistemas EUV ahora contienen un ambiente de hidrógeno mínimamente absorbente que mantendrá limpias las superficies de los elementos ópticos sin oxidarlos. Sin embargo, se sabe que el hidrógeno también causa ampollas [9].
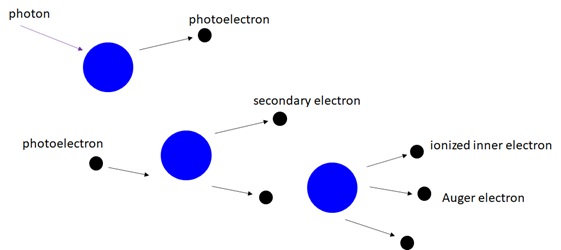
Los electrones también se dispersaron desde el sitio original de absorción de fotones, lo que provocó que la imagen definida originalmente se volviera borrosa. Los efectos de este desenfoque se sienten fácilmente a varios nanómetros de distancia. Lo que agrava aún más el efecto de propagación es la aleatoriedad inherente de toda la cadena de eventos.
EUV revela la naturaleza estocástica de la litografía
La absorción de fotones y la dispersión de electrones son eventos inherentemente aleatorios. Estos conducen a la falta de uniformidad del CD y a la rugosidad de los bordes, e incluso a errores de colocación y defectos graves. Los efectos estocásticos son más serios con una menor densidad de fotones absorbidos. Las resistencias más delgadas reducen la absorción, potenciando este efecto. Sin embargo, el aumento de la densidad de fotones conduce a un aumento de la densidad del número de electrones y a un aumento de la borrosidad de los electrones, cuya aleatoriedad conduce a defectos estocásticos [10]. La litografía DUV no se había ocupado de los problemas estocásticos principalmente porque los tamaños de las características eran lo suficientemente grandes como para asegurar suficientes fotones, pero EUV no pudo aprovechar este beneficio.
Referencias
- Antoni et al., Proc. SPIE 4146, 25 (2000).
- Tanabe, Proc. SPIE 11854, 1185416 (2021).
- J. Lin, J. Micro/Nanolith., MEMS y MOEMS 1, (2002).
- https://www.imec-int.com/en/articles/high-na-euvl-next-major-step-lithography
- Davydova y col., Proc. SPIE 12494, 124940Q (2023).
- https://www.youtube.com/watch?v=1HV2UYABh4E
- https://www.youtube.com/watch?v=agMx-nuL_Qg
- https://www.youtube.com/watch?v=sb46abCx5ZY
- https://www.youtube.com/watch?v=FZxzwhBR5Bk&t=3s
- https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen
Lea también
SPIE 2023: imec se prepara para EUV de alta NA
Patrón de máscara curvilínea para maximizar la capacidad de litografía
Comprobaciones de realidad para EUV de alta NA para nodos de 1.x nm
Comparte esta publicación a través de:
- Distribución de relaciones públicas y contenido potenciado por SEO. Consiga amplificado hoy.
- PlatoAiStream. Inteligencia de datos Web3. Conocimiento amplificado. Accede Aquí.
- Acuñando el futuro con Adryenn Ashley. Accede Aquí.
- Compra y Vende Acciones en Empresas PRE-IPO con PREIPO®. Accede Aquí.
- Fuente: https://semiwiki.com/lithography/329464-a-primer-on-euv-lithography/



