La función de dispersión de puntos es la métrica básica que define la resolución de un sistema óptico [1]. Un punto enfocado tendrá un diámetro definido por el disco de Airy [2], que en sí mismo es parte del patrón de difracción, basado en una función de Bessel de primer tipo y primer orden J1(x), siendo x una coordenada normalizada definida por pi*radius/(1 longitud de onda/NA), siendo NA la apertura numérica del sistema. La intensidad es proporcional al cuadrado de 1J0.5(x)/x. El perfil de intensidad es la función de dispersión de puntos, ya que es el patrón definido más pequeño posible que puede ser enfocado por una lente (o espejo). El ancho completo a la mitad del máximo (FWHM) se estima de cerca en 2 longitud de onda/NA. Los patrones DUV suelen ser mucho más pequeños que este tamaño (hasta ~1 longitud de onda/NA) y, por lo tanto, se requiere que sean conjuntos densos y usen máscaras de cambio de fase [0.5].
En el contexto de la litografía EUV, hay sistemas NA de 0.33 y sistemas NA de 0.55 con un oscurecimiento central del 20 %. Este último requiere una modificación de la función de dispersión de puntos restando la función de dispersión de puntos correspondiente a la parte oscurecida. Para un oscurecimiento central del 20%, este 0.4 J1(0.2x)/x, es decir, la intensidad es proporcional al cuadrado de [2J1(x)/x – 0.4 J(0.2x)/x]. Las funciones de dispersión de puntos para los sistemas EUV de 0.33 NA y 0.55 NA se representan a continuación.
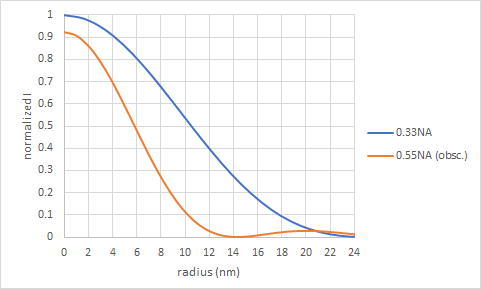
El sistema 0.55 NA tiene un FWHM más estrecho, ~12.5 nm frente a ~21 nm para 0.33 NA. Sin embargo, la NA más grande se desenfoca más rápido para una distancia de desenfoque dada debido a las mayores diferencias de trayectoria óptica entre el centro y el borde [4]. Además, las funciones de dispersión de puntos EUV medidas experimentalmente [5] indicaron un contraste muy reducido de lo esperado de una función de dispersión de puntos FWHM de ~22 nm para un sistema de 13.5 NA de longitud de onda de 0.3 nm. Esto se puede atribuir a aberraciones, pero también incluye efectos de rango relativamente largo específicos de la resistencia, que se pueden atribuir a fotoelectrones y electrones secundarios resultantes de la absorción de EUV [6].
Como se indicó anteriormente, los tamaños de punto más pequeños que la función de dispersión de puntos solo son posibles para tonos densos, con un límite de tono inferior de 0.7 longitud de onda/NA. Sin embargo, para arreglos lógicos aleatorios en interconexiones, los pasos tienen que ser mucho más grandes y, por lo tanto, los cortes de línea, por ejemplo, todavía están limitados por la función de dispersión de puntos. En los sistemas EUV 0.33 NA actuales, por ejemplo, se puede ver que la función de dispersión de puntos ya cubre tonos de línea objetivo populares en el rango de 28-36 nm. Entonces, de hecho, la ubicación de los bordes de la superposición y la orientación de CD, agravada por la dispersión de los electrones secundarios [6,7], parece prohibitiva. No es de extrañar, entonces, que SALELE (Litho-Etch-Litho-Etch autoalineado) haya sido la técnica predeterminada, incluso para EUV [8-11].
Referencias
[1] https://en.wikipedia.org/wiki/Point_spread_function
[2] https://en.wikipedia.org/wiki/Airy_disk
[3] YT. Chen y col., Proc. SPIE 5853 (2005).
[4] Un modelo simple de nitidez en cámaras digitales: desenfoque, https://www.strollswithmydog.com/a-simple-model-for-sharpness-in-digital-cameras-defocus/
[5] JP Cain, P. Naulleau y C. Spanos, Proc. SPIE 5751 (2005).
[6] Y. Kandel et al., Proc. SPIE 10143, 101430B (2017).
[7] F. Chen, La aleatoriedad del desenfoque de electrones secundario como el origen de los defectos estocásticos de EUV, https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen
[8] F. Chen, SALELE Patrón doble para nodos de 7nm y 5nm, https://www.linkedin.com/pulse/salele-double-patterning-7nm-5nm-nodes-frederick-chen
[9] R. Venkatesan y col., Proc. SPIE 12292, 1229202 (2022).
[10] P. Lin et al. proc. SPIE 11327, 113270X (2020).
[11] Y. Drissi et al., "Proceso SALELE desde la teoría hasta la fabricación", Proc. SPIE 10962, 109620V (2019).
Este artículo apareció por primera vez en LinkedIn Pulse: Límites de resolución de litografía: la función de dispersión de puntos
Lea también
Intercambio entre resolución y tamaño del troquel debido a la rotación de la pupila EUV
Litografía específica de la aplicación: Sub-0.0013 um2 Patrón de nodo de almacenamiento DRAM
Comparte esta publicación a través de:
- Distribución de relaciones públicas y contenido potenciado por SEO. Consiga amplificado hoy.
- Platoblockchain. Inteligencia del Metaverso Web3. Conocimiento amplificado. Accede Aquí.
- Fuente: https://semiwiki.com/lithography/325923-lithography-resolution-limits-the-point-spread-function/



